Устройство контроля глубины травления LEP400 - Применение Модельный ряд системы LEP400
Программный пакет EtchDirector для LEP400
Применение системы LEP400
Устройства серии LEP400 отличаются эксплуатационной гибкостью и могут успешно применяться как в сфере НИОКР, так и в крупносерийном производстве. Приборы пригодны для применения с широким перечнем материалов и в разных отраслях промышленности, в том числе:
Режимы интерферометрии и рефлектометрии
Квантово-каскадное лазерное травление GaAs/AlGaAs
Травление в рамках технологии анализа отказов: SiO2 на алюминии
Травление металла
Селективное плазменное травление с малым повреждением поверхности
Травление кремния для МЭМС (MEMS) при помощи ИСП-процесса ('Bosch')
Материалы |
|
Процессы |
III-V |
Кремний |
II-VI |
РИТ (RIE) |
ИСП (ICP) |
Полимеры |
Диэлектрики |
Газовое травление |
ЭЦР (ECR) |
|
Металлы |
|
|
|
Виды продуктов |
Оптоэлектроника
Лазер / Модуляторы / Приемники (детекторы) |
|
Кремний
КМОП (CMOS), щелевая изоляция,
утонение пластин, межслойные переходы |
|
МЭМС (MEMS)
Газовое травление
Глубокое травление кремния |
|
Электроника III-V
ВПЭ-транзисторы (HEMT), биполярные гетеротранзисторы (HBT) |
Фотомаска
Травление металлических материалов |
Упаковочные материалы
Топографические поверхности |
Биокристаллы
Микроканалы |
Анализ отказов |
Режимы интерферометрии и рефлектометрии
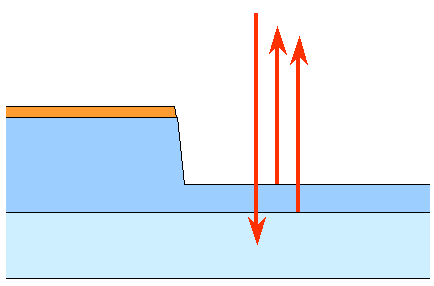 |
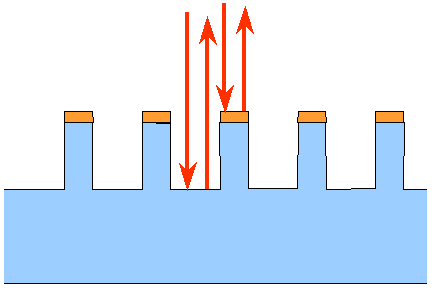 |
Интерферометрия |
Рефлектометрия |
Прибор LEP400 и поставляемое в комплекте моделирующее программное обеспечение идеально подходят для работы как в режиме интерферометрии, так и в режиме рефлектометрии.
В режиме интерферометрии оператор располагает лазерное пятно над открытым участком материала, подвергаемого травлению. Отраженный сигнал – это комбинация сигналов от каждого слоя образца. Таким образом, система прекрасно подходит для контроля скорости травления и определения точек завершения в отношении образцов с двумя и более слоями. Могут использоваться как подложки с кристаллической решеткой, так и подложки без кристаллической решетки. В разделах, приведенных ниже, описано множество примеров.
В режиме рефлектометрии оператор размещает лазерное пятно таким образом, что отражение происходит как от поверхности, защищенной маской, так и от поверхности травления. Подобное решение отлично подойдет для травления многослойных структур. В качестве примера можно привести травление кварца для дифракционных оптических элементов.
Современные инструменты моделирования, которыми оснащена система LEP400, также поддерживают одновременную работу с рефлектометрией и интерферометрией (например, травление тонкорешетчатой структуры в III-Vs).
Квантово-каскадное лазерное травление GaAs/AlGaAs
 |
 |
Модель EtchDirector© |
Обработанные данные |
Используя инструменты моделирования EtchDirector, было смоделировано более 200 слоев (окно слева).
В окне справа представлены результаты мониторинга реального цикла травления. Система LEP400 воспроизвела данные модели с высокой степенью точности и определила все экстремумы, что позволит использовать смоделированную схему травления в дальнейшем и добиваться высокой степени точности при завершении процесса (в точке завершения).
Благодаря сочетанию средств моделирования и мониторинга в системе LEP400 устранена необходимость в выполнении ряда предварительных процедур наладки и циклов испытаний, достигается экономия времени и сокращение расхода дорогостоящих подложек с эпитаксиальным слоем.
Степень достоверности, которая может быть достигнута при использовании прибора LEP400, имеет еще большее значение для устройств, требующих проведения травления в несколько этапов.
Достижимая точность завершения процесса травления в данном случае составляет приблизительно 5 нм.
Травление в рамках технологии анализа отказов: SiO2 на алюминии
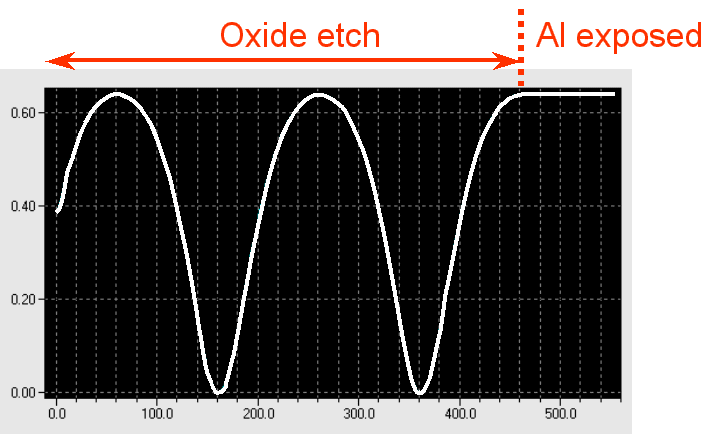
Как обозначено на схеме выше, устройство LEP400 может использоваться для контроля протравливания диэлектрика на металлической подложке в некоторых процессах, в том числе, при анализе отказов. Прибор LEP400 контролирует небольшую (диаметром примерно 30 микрон) экспонированную область и, таким образом, идеально подходит для мониторинга одного маленького кристалл в камере – в отличие от оптической спектрометрии, где возникнут сложности в подобном мониторинге.
Программа EtchDirector использует современные алгоритмы на основе точек завершения для определения «прямой линии», фиксируемой в конце процесса травления. При проведении эксплуатационных испытаний программа EtchDirector определяет точку завершения гораздо быстрее опытного оператора, таким образом позволяя избежать нежелательного удаления, повреждения либо загрязнения алюминиевой подложки (Al). При помощи алгоритма с использованием точек завершения оператор может также задать время перетравления, чтобы еще в большей степени улучшить качество процесса травления.
Основным преимуществом данного алгоритма является то обстоятельство, что надежность определения точек завершения не зависит от начальной толщины оксида. Данное условие имеет особенно большое значение в производственных процессах, где предварительное измерение толщины оксида является очень дорогостоящей и затратной по времени процедурой.
Устройство LEP400 идеально подходит для контроля процесса травления SiN на металле либо даже комбинаций SiN на SiO2 либо на Si.
Травление металла
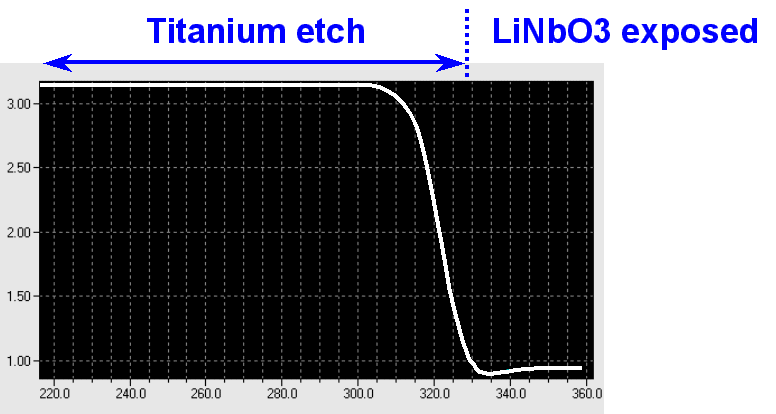
Металлы не прозрачны (прозрачными могут быть только очень тонкие металлические слои), и поэтому вы не сможете наблюдать интерференционные полосы и отслеживать глубину травления и скорость травления структуры металлических слоев.
Тем не менее, прибор LEP400 способен различать границы разделов, на которые указывает шаговое изменение уровня отражательной способности. В предыдущем примере титан подвергается травлению с подложкой LiNbO3. В процессе контроля при 670 нм наблюдается резкое снижение уровня сигнала при глубине травления менее 30 нм. Программный продукт EtchDirector поставляется с программным алгоритмом на основе определения точек завершения, разработанным специально для определения данного шагового изменения уровня и предоставляющим оператору возможность выбора точки остановки процесса (в верхней точке, в середине либо в нижней точке кривой). Также добавлена функция защиты от перетравления, позволяющая добиться наилучших результатов в процессе травления.
Основным преимуществом данного алгоритма является то обстоятельство, что надежность определения точек завершения не зависит от начальной толщины металла. Данное условие имеет особенно большое значение в производственных процессах, где предварительное измерение толщины металла является очень дорогостоящей и затратной по времени процедурой.
Данный процесс успешно применяется также при высоких скоростях травления и зарекомендовал себя как более скоростной и точный метод контроля по сравнению со схемой управления, где контроль осуществляет опытный оператор. Данный алгоритм контроля также прекрасно подходит для других металлов, включая NiCr, Ni, Au, Tg, Pt и т.д., позволяя использовать широкий перечень различных подложек.
Селективное плазменное травление с малым повреждением поверхности
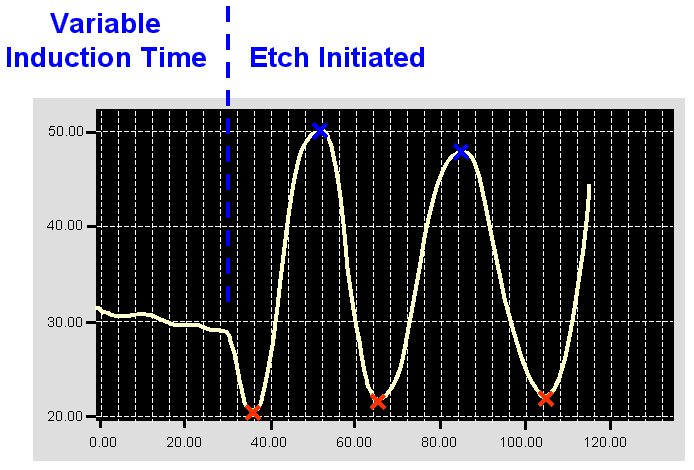
Селективное плазменное травление с малым повреждением поверхности находит применение в некоторых процессах, таких как травление соединений III-V (ВПЭ-транзисторы InP & GaAs) и активных оптоэлектронных элементов, включая лазеры, модуляторы и детекторы. Часто в данном случае при травлении отмечается индукционный период, в течение которого исходный оксидный слой и/или остатки от предыдущей стадии процесса препятствуют травлению. После удаления этого слоя процесс травления протекает в обычном режиме.
Проблемой является то обстоятельство, что продолжительность этого начального периода может составлять значительную часть ожидаемой продолжительности травления. Без осуществления контроля методом in-situ существует риск предоставления недостоверной информации о глубине травления.
Система LEP400 позволяет оператору буквально «наблюдать» индукционный период, как проиллюстрировано на предыдущем графике, и добиваться высокой точности и повторяемости процесса травления.
Травление кремния для МЭМС (MEMS) при помощи ИСП-процесса ('Bosch')
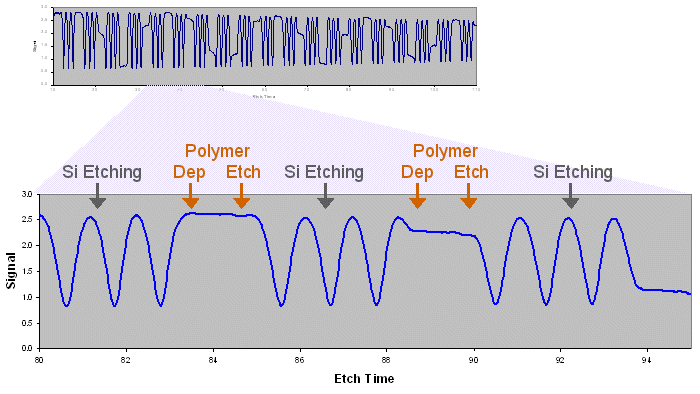
ИСП-процесс (Bosch-процесс) широко применяется в травлении кремниевых микроструктур в сфере МЭМС и позволяет добиться крайне высоких скорости травления (> 20 микрон в минуту) и значения относительного удлинения (> 100:1). Это процесс, включающий несколько попеременно чередующихся стадий травления кремния, осаждения полимера, протравливания полимера, травления кремния. Данный процесс протекает циклически до момента достижения требуемой глубины травления.
Несмотря на то, что процесс прекрасно зарекомендовал себя, необходимо обратить внимание на ряд особенностей. Во-первых, на скорость травления в значительной степени влияют размеры боковой поверхности и соотношение «площадь маскирующего слоя – открытая поверхность». Во-вторых, время протравливания полимера является переменной величиной, так как зависит от параметров глубины травления, а также от геометрических характеристик маскирующего слоя, и вследствие этого параметр не может быть проконтролирован оператором. Ситуация дополнительно осложняется тем, что точные параметры травления часто корректируются для того, чтобы добиться вертикальности и гладкости в соответствии с определенной моделью маскирующего слоя.
Это означает, что каждый раз, когда используется новая модель маскирующего слоя либо параметры травления подвергаются корректировке, необходимо провести пробные циклы для измерения глубины травления и определения скорости травления, что занимает много времени.
Использование устройства LEP400 позволяет пропустить все эти стадии и также устраняет необходимость в измерении глубины травления по окончании процесса травления при помощи профилометра.
Программный продукт EtchDirector основан на применении запатентованных высокоскоростных алгоритмов распознавания, позволяющих регистрировать форму отраженной волны и, таким образом, контролировать травление кремния (исключая этапы осаждения полимера и протравливания). Устройство LEP400 может осуществлять контроль с высокой точностью при скорости травления сверх 20 микрон в минуту.
| 



